芯片焊锡焊接方式及设备选择
发布时间:2021-07-31
来源:欧力克斯
已被浏览:2159次
分享到:
随着科技的发展,智能设备越来越小型化,半导体器件和组件在各个领域都得到了广泛的应用。特别是在移动设备、智能穿戴设备、航空航天等的大量应用对其可靠性提出了较高的要求,其中芯片的焊接(粘贴)方式也是对其可靠性非常重要的一个环节。
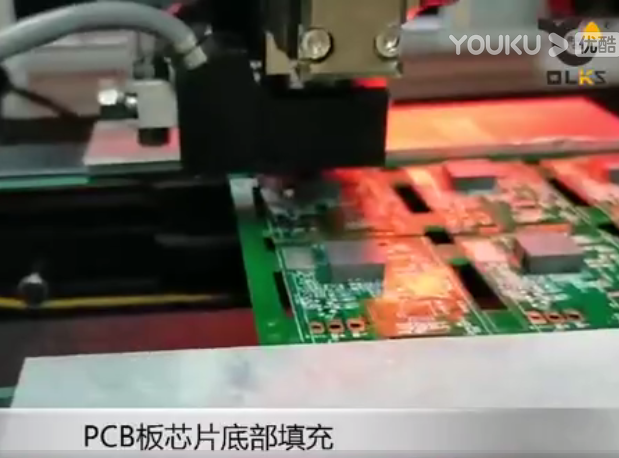
芯片到封装体的焊接是指半导体芯片与载体(封装壳体或基片)之间形成牢固的、传导性或者绝缘性的连接方法。焊接层除了为器件提供机械连接和电连接之外,还需为器件提供良好的散热通道。下面将针对芯片的焊接或粘贴方式进行一个详细的说明。
一、非导电连接
在芯片到封装体的焊接,有时芯片的背面无需将其电性能引出,因此会用非导电胶黏住芯片起到固定芯片位置的作用。这种非导电胶内部主要以高分子树脂体系为主,添加二氧化硅、氧化铝、氮化硅等填料来提升材料的导热性和绝缘性。非导电胶在实际使用的过程中可以通过点胶、丝网印刷等方式进行使用,然后通过加热完成树脂体系固化之后将芯片与基材焊接在一起。
二、导电胶连接
芯片封装中还有一种是要形成牢固的、传导性的连接方法,即导电互联。导电互联的方式也很多种,如导电胶连接、金属连接等。
导电胶是指在高分子树脂粘合剂中添加了导电的金属颗粒来实现其导通功能。在这中高分材料中,环氧树脂是最经常使用的。环氧树脂是稳定的线性聚合物,在加入固化剂后,环氧基打开形成羟基并交链,从而由线性聚合物交链成网状结构而固化成热固性塑料。其过程由液体或粘稠液→凝胶化→固体。固化的条件主要由固化剂种类的选择来决定。而其中掺杂的金属含量决定了其导电、导热性能的好坏。
导电银浆是当前最流行的芯片粘贴方法之一,它所需的固化温度低,这可以避免热应力,但有银迁移的缺点。导电胶因其操作过程中载体不须加热,设备简单,易于实现工艺自动化操作且经济实惠而得到广泛应用,尤其在集成电路和小功率器件中应用更为广泛。但是使用导电胶的器件热阻和电阻都很高。树脂在高温下容易分解,有可能发生填料的析出,在粘贴面上只留下一层树脂使该处电阻增大。因此它不适于要求在高温下工作或需低电阻的器件。另外,导电银胶的机械强度远不如共晶焊接强度大。
三、焊锡(粘接)设备
芯片属于高精密设备,精度要求通常达到0.1-0.3mm左右,甚至更低,人工是无法完成焊接,需要借助精密喷射点胶设备完成。欧力克斯在线式喷射
锡膏焊锡机,精度可达0.2-0.3mm,最高频率50Hz,最小喷点直径0.2mm,最小画线直径0.3mm,最小锡膏量为1nL。

芯片通常采用环氧树脂封装,焊接。环氧树脂光固化倒装焊法这是一种微米凸点倒装焊接,与一般的FCB不同的地方在于,它是利用光敏树脂固化时产生的收缩力来将凸点与基板上的金属焊区牢固地互连在一起的,因此环氧树脂光固化不是“焊接”,而只是“机械接触”。这种FCB也称作机械接触法。其工艺步骤为:在基板上涂光敏树脂→芯片凸点与基板金属焊区对位贴装→加紫外(UV)光并且加压进行光固化,从而完成芯片的倒装焊过程。
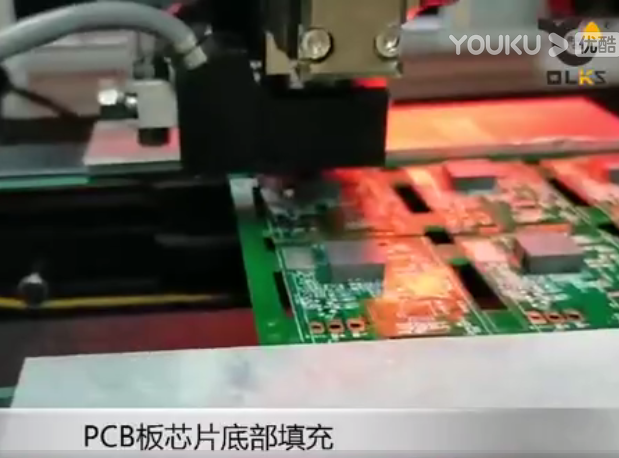
芯片到封装体的焊接是指半导体芯片与载体(封装壳体或基片)之间形成牢固的、传导性或者绝缘性的连接方法。焊接层除了为器件提供机械连接和电连接之外,还需为器件提供良好的散热通道。下面将针对芯片的焊接或粘贴方式进行一个详细的说明。
一、非导电连接
在芯片到封装体的焊接,有时芯片的背面无需将其电性能引出,因此会用非导电胶黏住芯片起到固定芯片位置的作用。这种非导电胶内部主要以高分子树脂体系为主,添加二氧化硅、氧化铝、氮化硅等填料来提升材料的导热性和绝缘性。非导电胶在实际使用的过程中可以通过点胶、丝网印刷等方式进行使用,然后通过加热完成树脂体系固化之后将芯片与基材焊接在一起。
二、导电胶连接
芯片封装中还有一种是要形成牢固的、传导性的连接方法,即导电互联。导电互联的方式也很多种,如导电胶连接、金属连接等。
导电胶是指在高分子树脂粘合剂中添加了导电的金属颗粒来实现其导通功能。在这中高分材料中,环氧树脂是最经常使用的。环氧树脂是稳定的线性聚合物,在加入固化剂后,环氧基打开形成羟基并交链,从而由线性聚合物交链成网状结构而固化成热固性塑料。其过程由液体或粘稠液→凝胶化→固体。固化的条件主要由固化剂种类的选择来决定。而其中掺杂的金属含量决定了其导电、导热性能的好坏。
导电银浆是当前最流行的芯片粘贴方法之一,它所需的固化温度低,这可以避免热应力,但有银迁移的缺点。导电胶因其操作过程中载体不须加热,设备简单,易于实现工艺自动化操作且经济实惠而得到广泛应用,尤其在集成电路和小功率器件中应用更为广泛。但是使用导电胶的器件热阻和电阻都很高。树脂在高温下容易分解,有可能发生填料的析出,在粘贴面上只留下一层树脂使该处电阻增大。因此它不适于要求在高温下工作或需低电阻的器件。另外,导电银胶的机械强度远不如共晶焊接强度大。
三、焊锡(粘接)设备
芯片属于高精密设备,精度要求通常达到0.1-0.3mm左右,甚至更低,人工是无法完成焊接,需要借助精密喷射点胶设备完成。欧力克斯在线式喷射
锡膏焊锡机,精度可达0.2-0.3mm,最高频率50Hz,最小喷点直径0.2mm,最小画线直径0.3mm,最小锡膏量为1nL。

芯片通常采用环氧树脂封装,焊接。环氧树脂光固化倒装焊法这是一种微米凸点倒装焊接,与一般的FCB不同的地方在于,它是利用光敏树脂固化时产生的收缩力来将凸点与基板上的金属焊区牢固地互连在一起的,因此环氧树脂光固化不是“焊接”,而只是“机械接触”。这种FCB也称作机械接触法。其工艺步骤为:在基板上涂光敏树脂→芯片凸点与基板金属焊区对位贴装→加紫外(UV)光并且加压进行光固化,从而完成芯片的倒装焊过程。

 18796870765
18796870765




































